異種チップ統合の最前線|3Dパッケージが切り拓く半導体進化の未来
カテゴリーblog
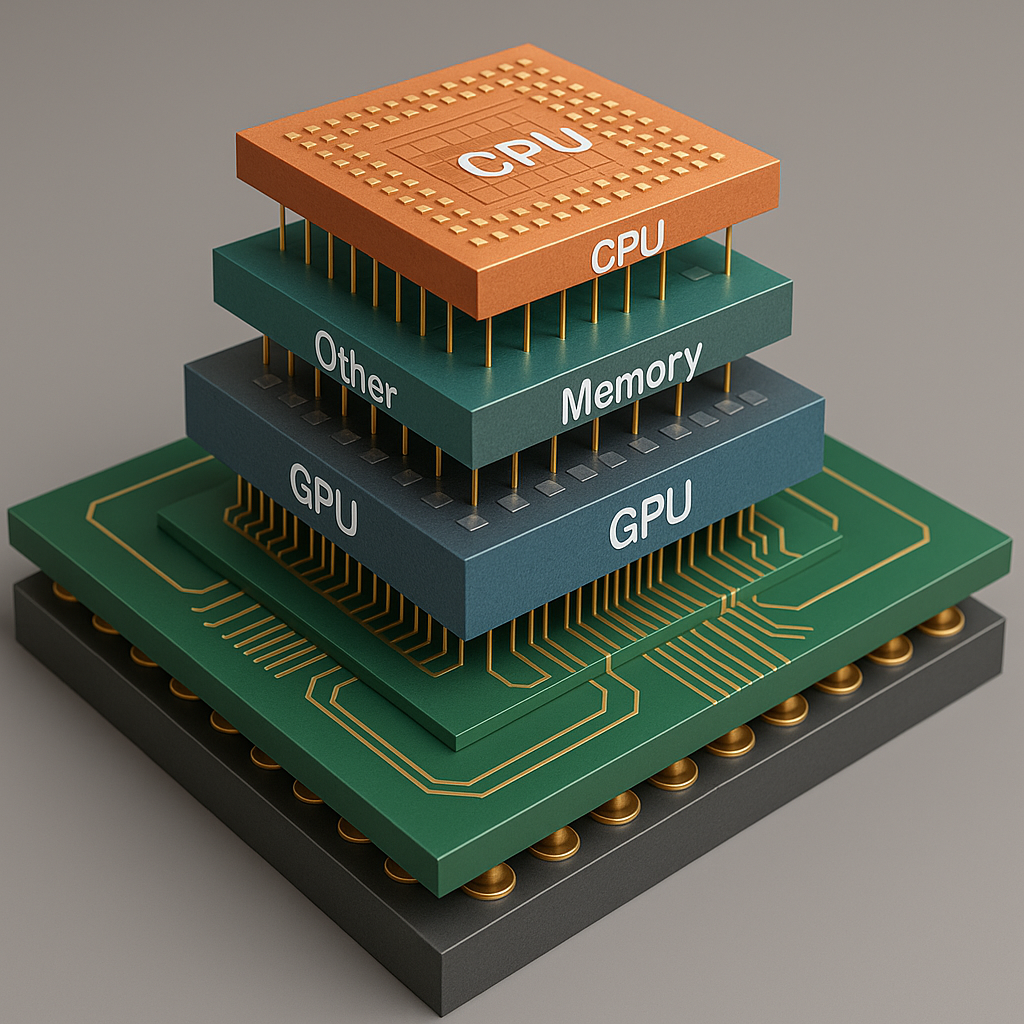
異種チップモジュール化と3Dパッケージとは
従来、CPU、GPU、メモリ、通信チップなどの各種機能はそれぞれ独立したICとして実装されてきました。しかし、デバイスの小型化・高性能化・省電力化の要求が高まるなか、**異なる種類のチップを1つのモジュールに集積する「異種チップモジュール化(Heterogeneous Integration)」**の技術が急速に発展しています。
この流れを加速するのが、「3Dパッケージ技術」です。従来の2Dパッケージとは異なり、複数のチップを垂直方向に積層することで、配線距離を短縮し、性能・電力効率を飛躍的に高めることが可能になります。
3Dパッケージがもたらす技術革新
3Dパッケージ技術にはさまざまなアプローチが存在します。
- TSV(シリコン貫通ビア)技術
積層チップ間の垂直配線により、信号伝送の高速化・省電力化を実現。 - Chiplet設計
各機能を分担するチップレットをインターポーザー上で統合することで、柔軟なシステム設計が可能に。 - Fan-out WLPや2.5D実装との融合
高密度配線と熱拡散性能を両立し、パッケージ全体の信頼性を向上。
異種チップ統合の応用分野
この技術は、以下のような先端領域で採用が進んでいます:
- スマートフォンやウェアラブル端末
限られたスペースで高性能を実現。 - AIプロセッサやHPC(高性能計算)
複雑な演算を支えるため、演算・メモリ・I/Oを近接配置。 - 車載システム
ADASや自動運転向けSoCの多機能統合に貢献。
今後の展望と課題
異種チップモジュール化と3Dパッケージ技術は、モノリシックな集積の限界を超え、カスタマイズ性と歩留まり向上を両立する革新技術として注目されています。ただし、熱対策・製造コスト・検査技術の高度化などの課題も残されており、エコシステム全体の進化が求められます。
このブログを書いた人

有限会社 長谷川加⼯所
代表取締役
長谷川 一英
HASEGAWA KAZUHIDE
切削加⼯の長谷川加⼯所について
切削加⼯で難しい産業部品を柔軟に製作。
アルミ・スレンレス・鉄 etc。
試作・⼩ロット量産。
詳しくはこちら

